| Solutions Critical Feature Analysis There was a time when Critical Dimension control was simply defined as the uniformity of feature widths measured across the field, wafer or lot. The new metrology platforms vary from optical scatter, ellipsometer to Scanning Electron Microscopes (SEM’s). These new tools measure not only critical feature width at multiple thresholds and accelerating voltages but also provide 3-D images of structure profiles; even edge roughness and film stack uniformity. Today, data sets encompassing over 10,000 measurements on a single wafer are appearing. Their analysis exceeds the capabilities of classic statistics if the user wishes to validate the metrology and derive tool and process control elements from the data. Weir PW's empirical models for spatial feature distribution provide the best means of controlling the process in this new paradigm. Select a product solution according to your needs below or directly click on a product name on the lower-right for more information. | 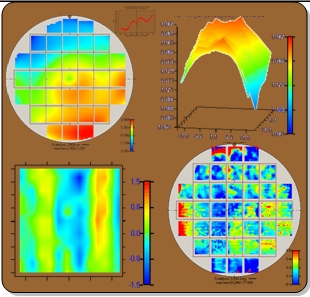  |
